
마스터 토토사이트新材料工程学部朴镇成教授研究团队于26日表示,以氧化物半导体(In₂O₃)为对象,将原子层沉积(Atomic Layer Deposition,ALD)与原子层刻蚀(Atomic Layer Etching,ALE)相结合,开发了即使在数纳米厚度下仍能保持结晶性并提升电学性能的新型原子层工艺(Atomic Layer Processing,ALP)。
研究团队依次结合了利用氢等离子体进行的表面还原阶段,以及利用有机配体(乙酰丙酮,Hacac)进行的去除步骤,实现了结晶性保持型 In₂O₃ 原子层刻蚀工艺。将该工艺应用于通过 ALD 生长的氧化物沟道并进行精密的 etch-back 处理后,结果显示即使在厚度仅为 3 nm 的超薄薄膜中,(222)优先生长取向仍得以保持,表面粗糙度也从0.27nm降低至0.17nm,成功同时确保了结晶性与表面质量。
尤其是,研究团队对相同厚度(3nm)的 In₂O₃ 沟道进行对比分析后发现,在仅采用 ALD 的工艺中,几乎难以形成结晶结构,载流子迁移率较低(~2cm²/V·s),且阈值电压不稳定性(ΔVTH ≈ −5.5 V)十分明显。而在ALD–ALE结合工艺中,则能够保持取向良好且晶粒尺寸较大的晶粒结构,迁移率显著提升(约 12 cm²/V·s),ΔVTH也改善至约 −0.75 V。
这一成果表明,通过 ALD–ALE 连续工艺克服了现有 ALD 工艺在“临界厚度(critical thickness)以下难以获得结晶性”的限制,在超薄环境下可抑制缺陷密度并实现优异的电学可靠性,提出了一种全新的工艺范式。
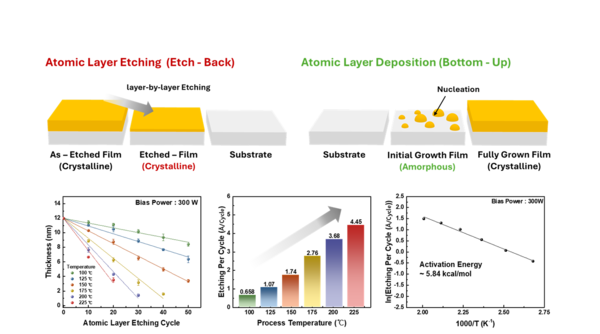
朴镇成教授表示:“本次研究在于实验性地验证了将 ALD 与 ALE 连续应用于氧化物半导体沟道的原子层工艺(Atomic Layer Processing)的可行性,这一点具有重要意义。该技术有望成为在 3D DRAM·3D NAND 等跨时代存储器、BEOL(后端工艺兼容)逻辑器件以及高分辨率显示用氧化物器件中,稳定实现了3 nm以下超薄沟道的核心基础技术。”
此外,朴教授还表示:“与等离子体刻蚀或反应性离子刻蚀(RIE)相比,ALE 通过自限制的逐层(layer-by-layer)反应,在最大程度降低损伤的同时,实现了对厚度·成分的精密控制。此次确立的结晶性保持 ALE 工艺可扩展应用于 IGZO、IGO 等多种氧化物半导体及高介电绝缘层,有望发展成为未来半导体新型器件设计的平台工艺。”
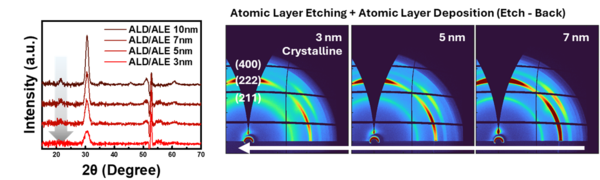
此次研究在韩国研究财团创新研究先导中心(IRC)项目的支持下进行,研究成果已在线发表于纳米器件·纳米工艺领域的国际知名学术期刊《ACS Nano》11 月刊。
此次论文《Crystallinity-Preserving Atomic Layer Etching of Ultrathin In₂O₃ for Stable Oxide Nanoelectronics》由마스터 토토사이트新材料工程学部金珉灿硕博连读课程学生担任第一作者,朴镇成教授担任通讯作者。

 '한양위키' 키워드 보기
'한양위키' 키워드 보기